4. CD-SEM - Что такое SEM критического измерения?

Критическое измерение SEM ( CD-SEM : Сканирующий электронный микроскоп критического размера) - это специальная система для измерения размеров тонких рисунков, сформированных на полупроводник вафля , CD-SEM в основном используется в производственных линиях электронных устройств полупроводники ,
Три основных CD-SEM особенности, которые отличаются от общего SEM:
- CD-SEM пучок первичных электронов, облучающий образец, имеет низкую энергию 1 кэВ или ниже.
Понижение энергии электронного пучка CD-SEM может уменьшить повреждение образца из-за зарядки или облучения электронным пучком. - CD-SEM Точность и повторяемость измерений гарантируется улучшением калибровки увеличения до максимальной степени.
Повторяемость измерений CD-SEM составляет около 1% 3σ от ширины измерения. - Точные замеры на пластине автоматизированы.
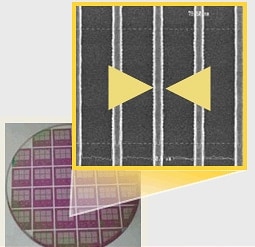
Измерение точного рисунка на пластине.Образец вафли помещается внутри вафельной кассеты (или стручка / FOUP ), который размещен на CD-SEM , Условия и процедуры измерения размеров вводятся в рецепт * заранее. Когда начинается процесс измерения, CD-SEM автоматически извлечет пластинку из кассеты, загрузит ее в CD-SEM и измерьте желаемые позиции на образце. Когда измерение закончено, пластина будет возвращена в кассету.
* Рецепт:
Рецепт - это программа (набор процедур, методов обработки, параметров и входных данных), вводимая в производственную систему, такую как CD-SEM.
Принципы измерения
CD-SEM использует уровень серого (контраст) сигнала изображения SEM.
- Во-первых, курсор (индикатор положения) указывает позицию измерения на изображении SEM.
- Профиль линии указанной позиции измерения затем получается. Профиль линии - это сигнал, который указывает на изменения в топографическом профиле измеряемого объекта.
- Профиль линии используется для получения размеров указанной позиции. CD-SEM рассчитывает размеры автоматически путем подсчета количества пикселей в области измерения.
Образ CD-SEM
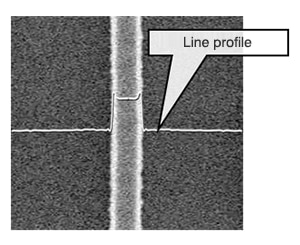
Fig.4-1. Линия фоторезиста (изображение SEM) и профиль линии
Пример изображения SEM, полученного CD-SEM показано ниже. На Рис.4-1 показан профиль линии, нарисованный поверх изображения SEM линии фоторезиста. Взаимосвязь между видом поперечного сечения линии фоторезиста и изображением SEM показана на фиг.4-2.
Кроме того, взаимосвязь между поперечным сечением линии и ее профилем линии показана на рис.4-3.
То есть изображение на рис.4-1 дает профиль линии, который, в свою очередь, дает ширину линии. Если поперечное сечение линии имеет форму трапеции, как на рис.4-3, ширина сверху и снизу будет отличаться. В этом случае позиция измерения будет указана в рецепте. Кроме того, желаемое положение высоты также может быть указано.
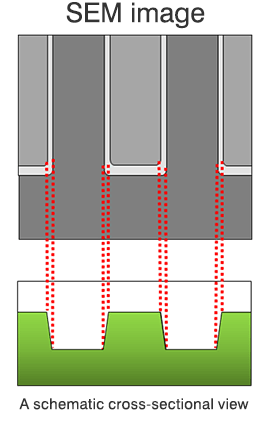
Fig.4-2. Связь между SEM-изображением линии и пространства и схематическим видом в поперечном сечении
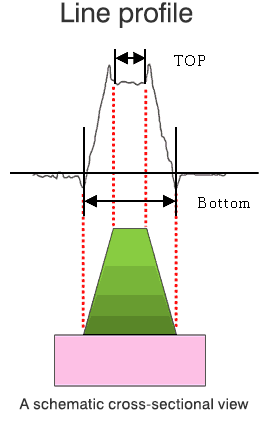
Fig.4-3. Связь между схематическим изображением поперечного сечения линии и профилем линии
Процесс измерения
Измерение критического размера в основном выполняется в следующих операциях процесса изготовления пластины.
Товары
Hitachi Advanced CD-SEM высокого разрешения
С тех пор как Hitachi выпустила свой первый CD-SEM в 1984 году, он последовательно следовал методу измерения критических размеров на основе изображения SEM, развивая и поддерживая превосходную воспроизводимость измерений в течение более 30 лет. Поддерживая высокое разрешение, совместимое с тенденцией полупроводникового микрообработки, Hitachi предлагает надежный CD-SEM, демонстрирующий высокую доступность и включающий различные новые функции, необходимые для линий производства и разработки, отвечающих потребностям клиентов.
Представляем линейку продуктов с усовершенствованным критическим измерением высокого разрешения - сканирующим электронным микроскопом (Hitachi CD-SEM)